DHI 보드 표면 처리 기술 탄소 시리즈 직접 도금
1. 카본 시리즈 직접 도금의 역사
탄소 계열 직접 도금 공정은 35 년 동안 회로 기판 산업에서 널리 사용되었습니다. 산업에서 널리 사용되는 프로세스에는 블랙홀, 일식 및 그림자가 포함됩니다. 원래 블랙홀 직접 도금 기술은 1984 년에 특허를 받았으며 도금 FR-4 스루 홀 패널 공정으로 상업적으로 성공했습니다.
블랙홀은 화학적 구리 싱크와 같은 산화 환원 공정이 아닌 코팅 공정이기 때문에이 기술은 다른 유전 물질의 표면 활동에 민감하지 않으며 금속 화하기 어려운 물질을 처리 할 수 있습니다. 따라서이 공정은 폴리 테트라 플루오로 에틸렌 (PTFE)과 같은 연성 회로, 고성능 또는 특수 재료의 폴리이 미드 필름에 널리 사용되었습니다. 탄소 및 흑연의 직접 도금 기술은 항공 우주 및 군용 항공 전자 공학 응용 분야에 대해 승인되었으며 IPC-6012D 사양의 섹션 3.2.6.1의 요구 사항을 충족합니다.
2.Circuit Board 개발
인쇄 회로 기판 설계의 필요성으로 인해 직접 전기 도금 공정이 지난 몇 년 동안 계속 발전했습니다. 소형화 드라이브로 인해 리드 구성 요소에서 표면 실장 구성 요소에 이르기까지 PCB 설계는 더 많은 핀이있는 마이크로 구성 요소에 맞게 발전하여 PCB 레이어가 증가하고 회로 기판이 더 두꺼워지며 스루 홀 직경이 더 작습니다. 높은 종횡비의 문제를 해결하기 위해 생산 라인의 기술 사양에는 초음파를 사용하여 기공을 빠르게 적시고 기포를 제거하는 것과 같은 용액 전달 및 미세 기공 교환의 개선이 포함되어야합니다. 두꺼운 회로를 효과적으로 건조하기 위해 에어 나이프 및 건조기를 개선하는 능력. 보드의 작은 구멍.
그 이후로 PCB 설계자들은 다음 단계에 진입했습니다. 막힌 구멍 굶주림, 핀 수 및 볼 그리드의 밀도가 드릴링 및 배선에 사용할 수있는 보드 표면을 초과합니다. 1.27mm ~ 1.00mm 그리드의 볼 그리드 어레이 패키지 (BGA) 및 0.80mm ~ 0.64mm 그리드의 칩 스케일 패키지 (CSP)를 통해 마이크로 블라인드 홀은 설계자가 HDI 기술의 과제를 해결하는 무기가되었습니다.
1997 년 피처 폰은 대량 생산을 위해 1 + N + 1 디자인을 사용하기 시작했습니다. 이것은 레이어 코어의 오버레이에 마이크로 블라인드 구멍이있는 디자인입니다. 휴대폰 판매가 증가함에 따라 사전 에칭 창과 CO2 레이저, UV, UV-YAG 레이저 및 UV-CO2 레이저를 결합하여 마이크로 블라인드 홀을 형성합니다. 마이크로 블라인드 비아를 사용하면 설계자가 블라인드 비아 아래로 라우팅 할 수 있으므로 레이어 수를 늘리지 않고도 더 많은 핀 그리드를 재배포 할 수 있습니다. HDI는 현재 소형 제품, 고급 패키징 및 고성능 전자 제품의 세 가지 플랫폼에서 널리 사용됩니다. 휴대폰 디자인의 소형화는 현재 가장 생산적인 응용 프로그램입니다.
3. 직접 도금
블랙홀과 같은 직접 도금 시스템은 블라인드 홀 및 HDI 마이크로 비아의 금속 화 문제를 해결하기 위해 기술적 장애물을 극복해야합니다. 막힌 구멍의 크기를 줄이면 막힌 구멍 바닥의 탄소 입자 제거의 어려움이 증가하지만 막힌 구멍 바닥의 청결도가 신뢰성에 영향을 미치는 핵심 요소입니다. 따라서 새로운 클리너 및 마이크로 에칭 제의 개발은 실명을 개선하는 것입니다. 구멍 바닥을 청소하는 방법.
또한 이론과 실무 경험을 바탕으로 미세 침식 부의 노즐 설계를 스프레이-적임-스프레이 구성의 조합으로 수정 하였다. 연습은 효과적인 디자인임이 입증되었습니다. 노즐과 회로 기판 표면 사이의 거리가 줄어들고 노즐 사이의 거리가 줄어들며 회로 기판에 대한 스프레이 충격력이 증가합니다. 세부 사항을 파악함으로써 새로운 노즐 디자인은 구멍과 막힌 구멍을 통해 높은 종횡비를 효과적으로 처리 할 수 있습니다.
차세대 스마트 폰의 개발과 함께 제조업체는 스택 된 블라인드 홀 디자인의 레이어를 사용하여 구멍을 통해 제거하기 시작했으며, 이는 선 너비와 줄 간격이 60μm에서 40μm, 회로 생산으로 감소한 추세를 촉발 시켰습니다. 보드 과정에서 사용되는 원래 구리 호 일 두께는 꾸준히 18 μm에서 12 μm에서 9 μm까지 감소됩니다. 그리고 레이어 회로 기판의 각 중첩 된 레이어는 한 번 금속 화 및 전기 도금해야하므로 습식 공정의 용량 요구량이 크게 증가합니다.
스마트 폰은 또한 플렉시블 및 리지드-플렉스 회로의 주요 사용자입니다. 기존 화학 구리 도금 공정과 비교하여 모든 층, 연성 회로 기판 (FPC) 및 리지드-플렉스 회로 기판 생산에 직접 도금 적용이 크게 증가했습니다.이 공정은 기존 화학 구리 공정과 비교되기 때문입니다. , 물 사용량 감소, 폐수 발생 감소
4. PCB의 점점 좁아지는 선폭 / 라인 간격 요구 사항은 엄격한 에칭 깊이 제어를 필요로합니다.
이제 최신 스마트 폰과 고급 패키징은 점차적으로 대체 반 가산 방식 (mSAP)을 채택하고 있습니다. mSAP는 3μm 초박형 호일을 사용하여 30/30 미크론 선 너비와 피치 설계를 달성합니다. 초박형 동박을 사용하는 생산 공정에서는 각 공정에서 마이크로 에칭 홈의 바이트 부 식량을 정밀하게 제어해야합니다. 특히 전통적인 화학 구리 침지 및 직접 도금 공정의 경우 표면 구리 호일의 바이트 부식 정도를 매우 정확하게 제어해야합니다.
5. 장비 구성의 발전
mSAP 공정과 일치하도록 직접 도금 공정을 최적화하기 위해 여러 장비 설계가 전체 생산에 들어가기 전에 실험 라인에서 점진적으로 테스트되었습니다. 테스트 결과는 우수한 장비 설계를 통해 넓은 작동 범위에서 균일 한 전도성 탄소 코팅을 제공 할 수 있음을 보여줍니다.
예를 들어, 카본 시리즈의 직접 도금 공정에서 특허받은 롤러 구성은 카본 코팅을보다 균일하게 만들기 위해 사용됩니다. 그리고 생산 보드 표면의 탄소 증착 량을 줄이고 탄소 현탁액의 양을 줄이면서 동시에 막힌 구멍이나 관통 구멍의 모서리에 지나치게 두꺼운 탄소 층을 방지합니다.
포스트 마이크로 에칭 탱크의 장비 사양도 재 설계되었습니다. 막힌 구멍의 바닥이 100 % 완전히 깨끗한 지 여부는 제조업체의 가장 우려되는 품질 문제입니다. 막힌 구멍의 바닥에 탄소 잔여 물이 있으면 전기 시험 중 시험에 합격 할 수 있지만 전도 단면적이 감소하기 때문에 결합력도 감소하여 부재로 인한 파손이 발생합니다. 조립 중 열 스트레스의 문제 고장의 문제. 막힌 구멍의 직경이 기존의 100 마이크론에서 150 마이크론, 80 마이크론, 60 마이크론으로 감소함에 따라 마이크로 에칭 그루브의 장비 사양을 업그레이드하는 것이 제품 신뢰성에 중요합니다.
블라인드 홀 바닥의 탄소 잔류 물을 완전히 제거하는 공정 능력을 향상시키기 위해 마이크로 식각 탱크의 장비 사양을 수정하기위한 테스트 및 연구를 통해 양산 라인에 적용되었습니다. 첫 번째 주요 개선 사항은 이중 에칭 홈을 사용하여 바이트 양을보다 정밀하게 제어하는 것입니다. 첫 번째 단계에서는 구리 표면의 대부분의 탄소가 제거되고 두 번째 단계에서는 탄소 입자가 대량 생산 보드로 되돌아가는 것을 방지하기 위해 신선하고 깨끗한 마이크로 에칭 용액이 사용됩니다. 두 번째 단계에서는 회로 기판 표면의 마이크로 에칭의 균일 성을 크게 향상시키기 위해 구리 와이어를 줄이는 기술도 채택되었습니다.
회로 기판 표면의 바이트 양의 가변성을 줄이면 블라인드 홀 바닥의 총 에칭 량을 정확하게 제어하는 데 도움이됩니다. 바이트 양의 가변성은 화학 농도, 노즐 설계 및 스프레이 압력 매개 변수에 의해 엄격하게 제어됩니다.
6. 화학 개선
화학적 개선 측면에서 전통적인 기공 세정제와 마이크로 에칭 포션을 테스트하고 수정하면서 바이트 부식을 제어하는 능력을 고려했습니다. 세정제의 유기 첨가제는 구리 표면에만 선택적으로 증착되며 수지 재료에는 증착되지 않습니다. 따라서 탄소 입자는이 특수 유기 코팅에만 증착됩니다. 회로 기판이 마이크로 에칭 홈에 들어가면 유기 코팅은 산성 액체에 대한 높은 용해도를 갖습니다. 따라서 마이크로 에칭 홈의 산에 의해 유기 코팅이 제거되고 동시에 탄소 입자 아래의 구리 표면이 측면 에칭되어 같은면의 탄소 입자 제거를 가속화 할 수 있습니다.
또 다른 개선 프로젝트는 2 성분 마이크로 에칭을 사용하면 탄소 입자 제거 능력을 향상시키고 구리 호일 표면의 미세 거칠기를 줄일 수 있다는 것입니다. 구리 표면의 거칠기가 건조 필름 접착에 도움이되도록하십시오. 테스트 결과는 막힌 구멍의 상대적으로 매끄러운 바닥이 막힌 구멍 바닥의 도금의 신뢰성을 향상시키는 데 도움이됨을 보여줍니다. 최적화 된 탄소 계열 직접 도금 공정 후 막힌 구멍 바닥의 구리 호일이 완전히 깨끗해져 전기 도금 된 구리가 구리 호일의 구리 격자에서 계속 성장하여 최고의 도금 접착력을 얻을 수 있습니다.
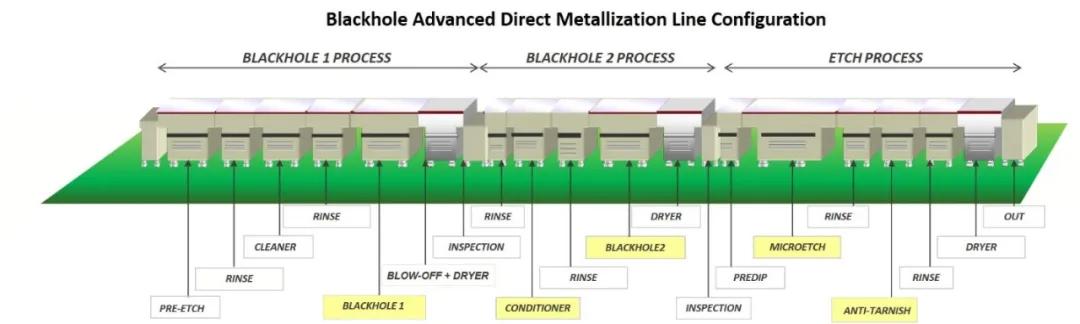
주요 공정 탱크와 화학 물질의 특정 개선 사항의 조합은 초박형 동박을 사용하는 생산에 적합한 고급 HDI / mSAP 공정을 구성합니다. 구리-구리 직접 결합의 단일 인터페이스를 통해 연속적인 금속 격자가 형성되어 막힌 구멍의 신뢰성이 향상됩니다. 마이크로 에칭 그루브의 처리는 막힌 홀의 바닥에있는 구리 호일의 이상적인 마이크로 거칠기가 홀 충전 전기 도금 된 구리 기판으로 사용될 수 있도록합니다. 이것은 구리 호일의 격자를 따라 막힌 구멍의 바닥에 전기 도금 된 구리 격자의 지속적인 성장을 촉진합니다. 정상적인 고온 열처리 후 구리 입자가 격자로 배열되어 완전한 연속 금속 격자를 형성합니다.
얇은 조각을 형성하기위한 FIB 절단 샘플의 관찰 및 분석은 인터페이스 라인이 입자 크기와 구조에서 균일 함을 보여줍니다 (그림 5). 열충격이나 열 순환 후 막힌 홀 바닥의 동박과 전기 도금 된 동과의 경계가 어렵습니다. 산화 또는 오염으로.

전기 도금 된 구리 층과 타겟 패드 사이의 인터페이스에 대한 집중 이온 빔 (FIB) 이미징으로, 선도적 인 직접 전기 도금 기술을 통해 강력한 구리-구리 결합이 열 스트레스에서도 잘 수행됩니다..
"블랙홀"과 같은 직접 전기 도금 생산 라인은 현재 3 미크론 초박형 동박의 대체 반 첨가제 (mSAP)의 대량 생산 공정에 사용됩니다. 이러한 시스템은 대량 생산에서 마이크로 에칭의 양을 정밀하게 제어하는 관련 장비를 사용합니다. 이 장비로 생산 된 12 단 회로 기판은 300 Cycle IST 테스트를 통과했습니다. 위 제품에서는 mSAP 공정을 이용하여 L2 / 10과 L3 / 11에 블랙홀을 사용하고 있습니다. 막힌 구멍의 크기는 80 ~ 100 x 45μm이며 각 회로 기판에는 2 백만 개의 막힌 구멍이 있습니다.
AOI를 사용하여 공정에서 탄소 잔류 물을 확인합니다. 검사 결과 5,000 PSM / 월 출력에서는 결함이 발견되지 않았습니다. 이러한 회로 기판의 전기 도금은 수직 연속 전기 도금 (VCP) 생산 라인에서 수행됩니다. 내부 층은 Tent-Etch 공정의 풀 플레이트 전기 도금을 채택하고 mSAP 층은 패턴 전기 도금이어야합니다. 그림 6의 전자 후방 산란 회절 (EBSD) 이미지는 타겟 패드와 전기 도금 된 구리 층 사이의 계면에서 입자 크기의 균일 성을 보여줍니다.